
Компания Engineering Ceramic Co. (EC © ™) Отчет:


Карбид кремния (SiC), как полупроводниковый материал третьего поколения, стал важным направлением развития технологии полупроводниковых материалов благодаря своим превосходным свойствам, таким как широкая запрещенная зона, высокая напряженность электрического поля пробоя и высокая теплопроводность. В цепочке полупроводниковой промышленности футеровка из карбида кремния Карбид кремния является основным материалом для производства пластин, а проверка качества материалов пластин из карбида кремния является ключевым звеном для обеспечения производительности. В полупроводниковой промышленности Китая обычно используемые технологии обнаружения монокристаллических подложек карбида кремния включают:

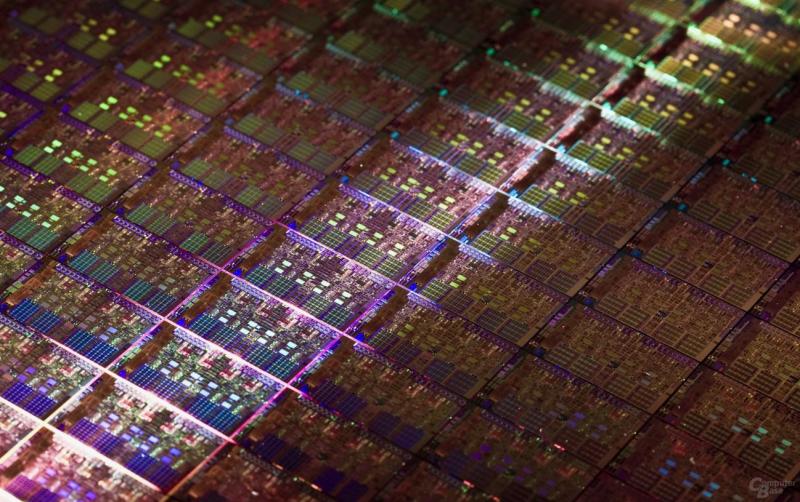
I. Геометрические параметры
Толщина
Суммарное изменение толщины, TTV
Поклон
Деформация
Следующий отчет об испытаниях взят из полностью автоматизированной системы вафель Corning Tropel® FlatMaster® FM200. Это оборудование в настоящее время широко используется в Китае.
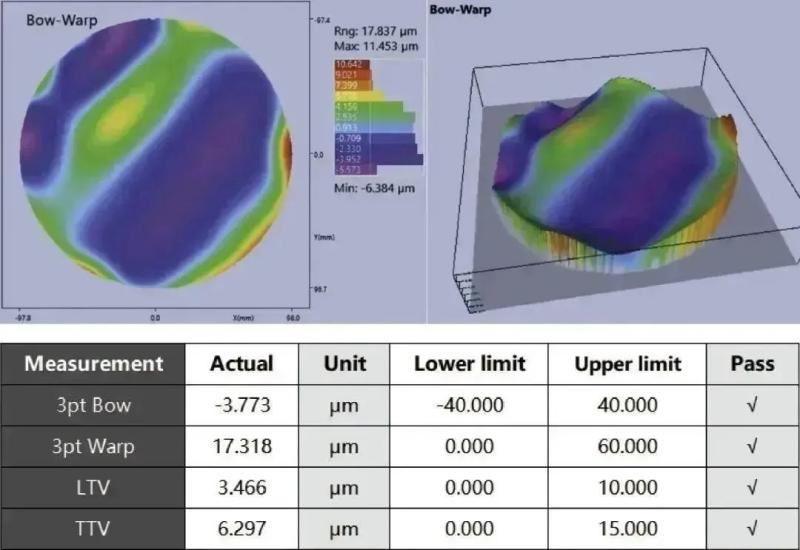

II. Дефект
В материалах подложки из монокристалла карбида кремния дефекты обычно делят на две основные категории: дефекты кристалла и поверхностные дефекты.
Точечные дефекты - ПД
Дефекты микротрубок - МП
Базальные плоские дислокации – БЛД
Краевые дислокации - TED
Ошибки штабелирования – SF
Винтовые дислокации - ТСД

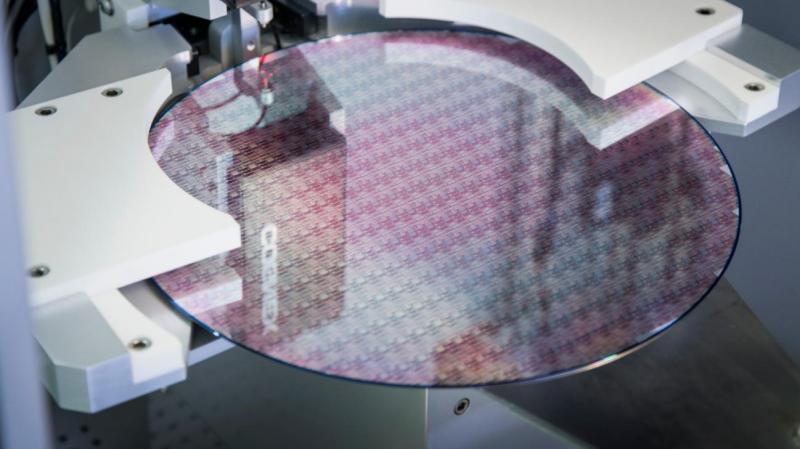
Технологии обнаружения поверхностных дефектов в основном включают в себя
Сканирующий длектронный микроскоп - СЭМ
Оптический микроскоп
Катодолюминесценция - CL)
Дифференциальный интерференционный контраст – DIC
Фотолюминесценция - PL
Рентгеновская топография - XRT
Оптический когерентный томограф - ОКТ
Рамановская спектроскопия - РС



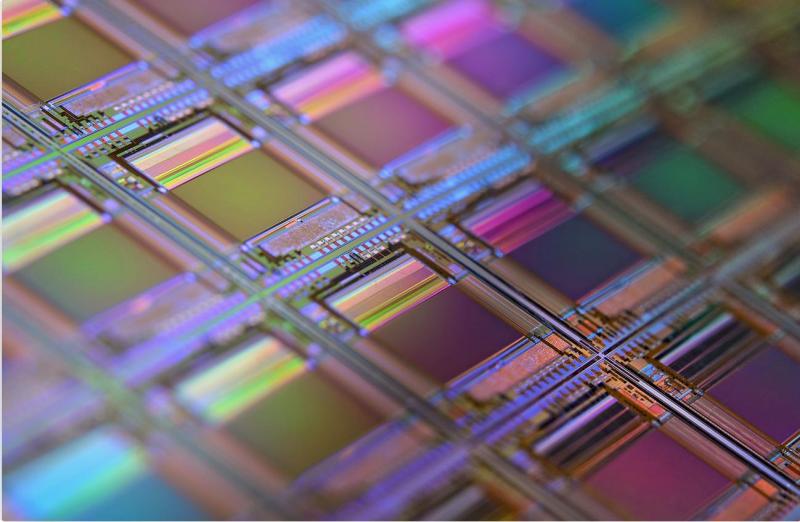

Заявление: Статья/новость/видео взяты из Интернета. Наш веб-сайт перепечатывается с целью обмена. Авторские права на перепечатанную статью/новость/видео принадлежат оригинальному автору или оригинальному официальному аккаунту. Если есть какое-либо нарушение, пожалуйста, сообщите нам вовремя, и мы проверим и удалим его.